Tootminetrükkplaadid (PCB-d)hõlmab mitmeid erinevaid protsesse, millest paljud nõuavad laserite kasutamist. UV-nanosekundiliste impulsslaserite kasutamine suureneb üha väiksemate vajalike avade tõttu.
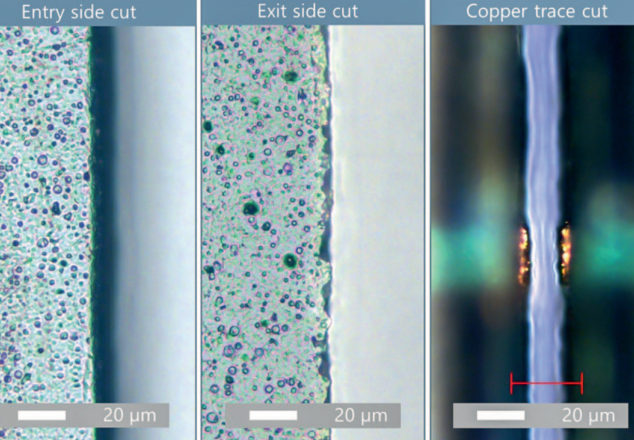
Seadmed ja moodulid muutuvad tänu arenenud pakkimistehnoloogiatele kompaktsemaks. Olles mõistnud, et pooljuhtsõlme ja PCB mõõtme vahel on suur erinevus – äärmuslikel juhtudel nanomeetrist millimeetrini – keskenduvad arendajad jätkuvalt täiustatud pakkimistehnoloogiate arendamisele, et ühendada erineva suurusega komponente. Üks selline tehnoloogia on süsteem-paketis (SiP) süsteem, kus üksikud integraallülituse (IC) seadmed ühendatakse enne lõplikku pakkimist ja eraldamist sisseehitatud metalljäljega PCB-substraadile. Arhitektuur sisaldab tavaliselt vahekihti, et saavutada PCB-s kiibiühenduste mõistlikult tihe jaotus. Moodulid paigutatakse lõpliku pakendamise ajal endiselt ühele suurele paneelile, kasutades tavaliselt epoksüvormimismassi (EMC) pakkimist või muid meetodeid. Seejärel eraldatakse moodulid laserlõikamisprotsessi abil.
Saagis, kvaliteet ja maksumus peavad ühtima
Ideaalne laser SiP eraldamiseks sõltub konkreetsetest nõuetest ja peab saavutama optimaalse tasakaalu läbilaskevõime, kvaliteedi ja kulude vahel. Kui tegemist on väga tundlike komponentidega, võib osutuda vajalikuks kasutada ultralühipulssi (USP) lasereid ja/või loomupäraselt madalaid soojusefekte.UV lainepikkused. Muudel juhtudel on sobivamad valikud madalama hinnaga, suurema läbilaskevõimega nanosekundilised impulss- ja pikalainelised laserid. SiP PCB substraadi lõikamise suure töötlemiskiiruse demonstreerimiseks katsetasid MKS-i rakendusinsenerid rohelist suure võimsusega nanosekundilist impulsslaserit. SiP materjali lõikamiseks kasutati Spectra-Physics Talon GR70 laserit, mis koosnes õhukesest FR4-st, mille vaskjuhtmed ja kahepoolne jootemask, kasutades kiiret multitöötlust kaheteljelise skaneeriva galvanomeetriga. Materjali kogupaksus on 250 µm, millest 150 µm on (üliõhuke) FR4 leht ja ülejäänud 100 µm kahepoolne polümeerist jootemask. Kasutades suurt skaneerimiskiirust, 6 m/s, saab leevendada tõsiseid termilisi mõjusid ja vältida kuumusest mõjutatud tsoonide (HAZ) teket. Pidades silmas suhteliselt õhukest materjali, kasutati väikest fookuspunkti suurust (umbes 16 µm, 1/e2 läbimõõt) ja kõrget impulsi kordussagedust (PRF) 450 kHz. See parameetrite kombinatsioon kasutab täielikult ära laseri ainulaadset võimet säilitada suurt võimsust kõrgel PRF-il (selles näites 67 W sagedusel 450 kHz), mis aitab säilitada õiget energiatihedust ja punkt-punktide kattumist suurel skaneerimiskiirusel.
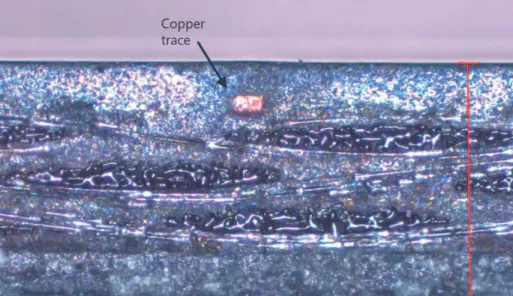
Lõikamine ilma termilise lagunemiseta
Pärast mitmekordset kiiret skaneerimist saavutati üldine võrgu lõikamise kiirus 200 mm/s. Joonisel 1 on kujutatud soone sissetulevad ja väljuvad küljed, samuti maa-alune ala, kus lõigatud tee ristub maetud vasktraadiga. Nii sissetulevad kui ka väljaminevad pinnad olid puhtalt lõigatud, ilma või vähese HAZ-iga. Lisaks ei mõjutanud vasktraadi olemasolu lõikamisprotsessi negatiivselt ja vask-soonte servade kvaliteet näis olevat ideaalne, kuigi vaatenurk oli mõnevõrra piiratud.
Vasktraadi (ja tõepoolest kogu lõike) ümbritseva kvaliteedi üksikasjalikuma ülevaate saamiseks vaadake lõike külgseina ristlõiget (joonis 2).
Kvaliteet on väga hea, ainult väga väikeses koguses HAZ-i ja üksikuid karboniseerunud ja tahkete osakeste fragmente. iga kiud FR4 kihis on selgelt eristatav ja sulanud osa piirdub lõigatud kiudude otspindadega, mis ulatuvad külgseintest väljapoole (st risti piki lõikepinda ulatuvate kiududega). Oluline on see, et nendes kihtides ei täheldatud delaminatsiooni.
Lisaks näitavad tulemused, et vaskjuhtmete ümbrus on hea kvaliteediga ega allu sellistele kahjulikele termilistele mõjudele, nagu vasevool või kihistumine ümbritsevast FR4 või jootemaski kihtidest.
Paksendatud FR4 plaadid, mis nõuavad suurt punkti läbimõõtu
Cutting thick FR4 for depaneling is a more mature PCB application for nanosecond pulsed lasers, where arrays of devices are separated from panels by cutting small connecting breakpoints, which was tested with the Talon GR70, for which an entirely new breakpoint cutting process was developed specifically for device panels consisting of approximately 900 µm thick FR4 boards. For this thicker material, the use of the largest possible focal spot diameter, while maintaining sufficient energy density (in J/cm2), is a key aspect of achieving the desired yield. Due to the laser's high pulse energy (>250 µJ) nominaalse PRF-i 275 kHz juures kasutati suuremat punkti suurust (~36 µm); pealegi on kiire kvaliteet suurepärane, fokuseeritud tala Rayleighi ulatus ületab 1,5 mm, mis on 1,5 korda materjali paksus. Selle tulemusena on koha suurus suhteliselt suur ja konstantne kogu materjali paksuse ulatuses, mis aitab kaasa tõhusale lõikamisele, kuna ühtlane kiiritusmaht ja sellest tulenevad laiad sooned hõlbustavad prahi eemaldamist. Joonisel 3 on kujutatud sissetulevad ja väljuvad mikroskoopilised kujutised lõikest, mida töödeldi mitme kiire skaneerimisega kiirusel 6 m/s (üldine lõikekiirus 20 mm/s).
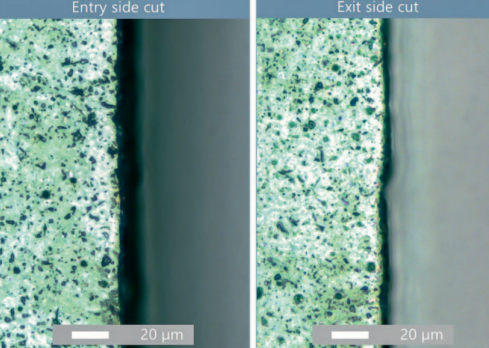
Sarnaselt SiP-plaatidele on nii sissetuleva kui ka väljamineva külje pinnakvaliteet väga hea ja tekitab minimaalset HAZ-i. Klaasi/epoksü FR4 substraadi ebahomogeensuse ja laserablatsiooni lõhe distaalses otsas oleva madala energiatiheduse tõttu kalduvad väljapääsu servad üldiselt täiesti sirgest joonest veidi kõrvale. Ristlõike külgseina pildistamine näitab üksikasjalikumat teavet lõhe kvaliteedi kohta (joonis 4 allpool).

Joonisel 4 on näha saavutatud suurepärast kvaliteeti. Lõikes moodustub vaid väike kogus HAZ-i ja süsinikuprodukte (koks). Lisaks ei sulanud peaaegu üldse klaaskiud. Kuni 20 mm/s võrgulõikekiirusega Talon GR70 sobib selgelt ideaalselt paksemate FR4 PCBde paneelide eemaldamiseks, tagades samal ajal suurepärase kvaliteedi ja suure läbilaskevõime.









